3D Bump検査装置発売のお知らせ
Bumpの高さを高速・高精度に検査。3D全数検査に対応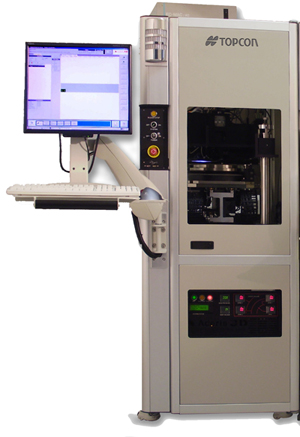
株式会社トプコン(本社:東京都板橋区、取締役社長:横倉 隆)は、各種半導体デバイス向けにBump(※1)の高さやサイズを高速・高精度に検査することができる3D Bump検査装置「Vi-Z800」を開発し、12月より販売を開始いたしますのでお知らせいたします。
当社は、半導体の前工程から後工程まで幅広い検査ニーズに対応すべく様々なタイプの各種検査装置をラインナップしています。なかでもチップ外観検査装置Viシリーズは、目視検査の置き換えとしての自動外観検査装置として各種半導体ウェーハの外観検査はもちろんのこと、LED、CCD/CMOSイメージセンサ、MEMSといった成長デバイス向けに販売を伸ばし検査装置として高い信頼を獲得しています。
今回新たに販売するVi−Z800は、半導体チップのBumpの高さ・コプラナリティー(※2)の他、変形不良、有無(Missing)、ブリッジ、面積、体積、位置ズレ等を検査することができる装置です。検査スピードの高速化によりBumpの高さを全数検査することで後工程への不良流失を防止することができ、さらに近年先端デバイスへ搭載が増えている数十μmレベルのマイクロBumpの高精度検査にも対応することができます。また、これまで当社製2Dのチップ外観検査装置Viシリーズを使用されているお客様は、データ・トランスファーが可能で、2D/3Dの検査結果を重ね合わせての工程内管理をすることで歩留り改善に強みを発揮できます。
当社外観検査装置Viシリーズは、セミオートモデル、イントレイモデル、汎用モデル、高速モデル、LED検査専用モデル、さらに今回開発した3D Bump検査装置を加えることで、今後ますます複雑化、そして多様化する外観検査の自動化ニーズに幅広い製品ラインナップで応えて行きます。
トプコンは、Viシリーズなどを中心とした各種グリーンデバイスを支える検査装置の開発、販売を通じ環境・省エネルギーに貢献してまいります。
【開発の背景】
携帯電話をはじめとしたデジタル家電の小型化・高機能化とともに電子デバイスの高密度実装の要求はますます高まり2Dから3D実装へと技術革新が進んでいます。こうしたなかで半導体チップのBump高さ検査のニーズは高まっていましたが、従来の3D Bump検査装置は、2D検査に比較して高さ方向の膨大なデータ処理が必要であるため、どうしても検査スループットが遅く、本来ウェーハの全数検査が望まれている中、サンプリングによる抜き取り検査での運用に限定せざるをえない状況でした。そこでトプコンは、高速・高精度でウェーハの3D全数検査を可能とした3D Bump検査装置「Vi-Z800」を開発致しました。
【特長】
- Solder Bump、Gold Bumpを高精度に検査
- ハイ・スループットで全数検査に対応
- マイクロBumpの高精度検査
- 2D外観検査装置Viシリーズとのデータトランスファー機能
※対応ウェハサイズ:100〜200mm又は200mm〜300mm
【その他】
標準価格:Vi-Z800 8,000万円〜(各種構成による)
販売開始:平成21年12月
販売目標:年間10台
*来る12/2(水)から開催のセミコン・ジャパン2009に出展いたします。
【用語解説】
※1 Bump(バンプ):数十ミクロン程度の外部接続用突起電極
※2 コプラナリティー:ウェーハ(またはパッケージ)内にあるBump上面高さの最大値と最小値との差








